特点及应用
HTCC材料信息
HTCC布板规则
主要参数
特点及应用
特点
- 四面带有对称的无引线焊盘,可输出DC~40GHz的控制信号或射频信号
- 芯区接地方式分为金属化接地或金属热沉接地满足不同芯片的散热需求
- 封装形式包含平行封焊、合金熔封、胶粘等多种封帽形式
- 尺寸小、重量轻、高频性能优异,适合小功率芯片封装
应用
- SIP、光通信、MEMS芯片、FPGA封装、CMOS图形传感器封装、车载、宇航等高可靠性芯片封装、毫米波HTCC基板
DPC & AMB
DPC 陶瓷基板
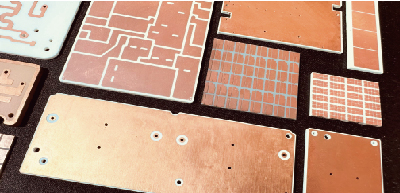
产品特点
- 基于高性能陶瓷材料:AL2O3、AIN、Si3N4、ZTA、高Q介质陶瓷等
- 高可靠性磁控溅射和电镀工艺
- 可选熟瓷激光成型工艺:高效低成本
- 可选生瓷成型工艺:高品质通孔和边缘质量
- 基材厚度范围0.3-3mm
- 镀层Cu、Ag、Sn、Ni、Au最大镀层厚度100um
应用
- 大功率激光器热沉、LED Submount、高导热热沉基板
- 无线通讯、射频微带电路
AMB 陶瓷基板
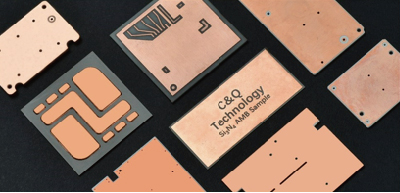
产品特点
- 基于高导热陶瓷材料:Si3N4、AlN、Al2O3等
- 高可靠性AMB钎焊浆料体系
- 基材厚度范围0.3-3mm
- 铜箔厚度100-800um
- 支持表面处理:Cu、Ag、Sn、Ni、Au
应用